-

-
TESCAN FIB-SEM-TOF-SIMS 雙束聚焦掃描電子顯微鏡-飛行時間二次離子質譜聯用系統

- 品牌:捷克泰思肯
- 型號: FIB-SEM-TOF-SIMS
- 產地:歐洲 捷克
- 供應商報價:¥8000000
-
上海愛儀通網絡科技有限公司
 更新時間:2025-05-30 09:32:31
更新時間:2025-05-30 09:32:31 -
銷售范圍售全國
入駐年限第4年
營業執照已審核
- 同類產品SEM 掃描電子顯微鏡(36件)

立即掃碼咨詢
聯系方式:18701866315
聯系我們時請說明在儀器網(www.oupniq.cn)上看到的!
掃 碼 分 享 -
為您推薦
產品特點
- 系統主要優勢:
高靈敏度,Be,B和Li之類的輕元素檢出限可達ppm級
優異的空間分辨率,橫向分辨<40nm,縱向分辨率<15 nm
正負離子均可檢測,離子質量分辨率>800
2維和3維快速、高離子質量分辨率和高空間分辨率成像,進行原位FIB深度分析
通過坐標轉移,保證不同儀器分析位置的重合
詳細介紹
TESCAN 電鏡質譜 FIB-SEM-TOF-SIMS 聯用系統
電子顯微分析是材料和生命科學微觀分析中最重要的一環,而元素分析是其中最重要的表征手段之一,但標準的分析手段如能譜儀和波譜儀存在很多不足,例如因靈敏度不足、空間分辨率較差,無法進行輕元素、微量元素的分析,無法分辨同位素等等,普通的分析手段已不能滿足現階段應用的需求。
TESCAN 提供的解決方案是將飛行時間二次離子質譜與 FIB-SEM 系統集成。這種組合能夠為用戶提供固體材料的 3D 化學表征和分子信息,高離子質量分辨率和高空間分辨率成像等,并可以進行原位 FIB 深度分析。
飛行時間-二次離子質譜(TOF-SIMS)
TOF-SIMS(Time of Flight Secondary Ion Mass Spectrometry) 是具有極高分辨率的質譜儀,工作原理是用聚焦離子束照射樣品表面,從而在樣品最上層的原子層激發出二次離子 (SI),再根據不同質量的二次離子飛行到探測器的時間不同來測定離子質量。
與 EDX 相比,TOF-SIMS 可以實現更好的橫向和縱向分辨率,還可以識別并定量樣品表面層中存在的元素和分子物質,以及具有類似標稱質量的同位素和其他物質等。
系統主要優勢:
ü 高靈敏度,Be,B和Li之類的輕元素檢出限可達ppm級
ü 優異的空間分辨率,橫向分辨<40nm,縱向分辨率<15 nm
ü 正負離子均可檢測,離子質量分辨率>800
ü 2維和3維快速、高離子質量分辨率和高空間分辨率成像,進行原位FIB深度分析
ü 通過坐標轉移,保證不同儀器分析位置的重合
應用案例:

1. 輕元素及微量元素分析:Li 離子電池中 LI+ 面分布分析
2. 通過低電壓和小束流 FIB 逐層減薄,成功區分出厚度為 2.5 nm 的摻有 0~15% 的 In 元素的 GaN 層
3. 金屬復合材料中微量元素的晶界偏析測定,檢出限可達 ppm 級
4. 對鈾礦石進行初期的同位素分析,快速得到 238U 和 235U 的分布信息
您可能感興趣的產品
-
 TESCAN FIB-SEM-TOF-SIMS 雙束聚焦掃描電子顯微鏡-飛行時間二次離子質譜聯用系統
TESCAN FIB-SEM-TOF-SIMS 雙束聚焦掃描電子顯微鏡-飛行時間二次離子質譜聯用系統
-
 TESCAN 電鏡質譜 FIB-SEM-TOF-SIMS 聯用系統
TESCAN 電鏡質譜 FIB-SEM-TOF-SIMS 聯用系統
-
 TESCAN AMBER 雙束聚焦掃描電子顯微鏡 FIB-SEM
TESCAN AMBER 雙束聚焦掃描電子顯微鏡 FIB-SEM
-
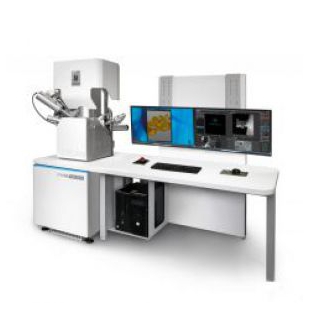 TESCAN SOLARIS 雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN SOLARIS 雙束聚焦掃描電子顯微鏡FIB-SEM
-
 二次離子飛行時間質譜
二次離子飛行時間質譜
-
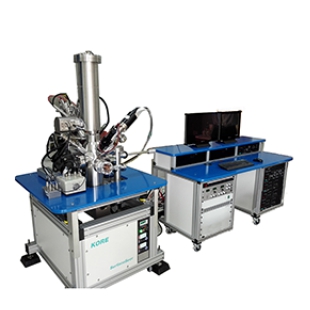 飛行時間二次離子質譜
飛行時間二次離子質譜
-
 TESCAN AMBER X 氙離子源雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN AMBER X 氙離子源雙束聚焦掃描電子顯微鏡FIB-SEM
-
 TESCAN SOLARIS X 氙等離子源雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN SOLARIS X 氙等離子源雙束聚焦掃描電子顯微鏡FIB-SEM
-
 TESCAN AMBER 高分辨率雙束聚焦掃描電鏡系統(FIB-SEM)
TESCAN AMBER 高分辨率雙束聚焦掃描電鏡系統(FIB-SEM)
-
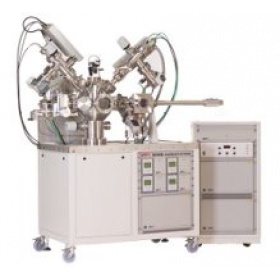 二次離子質譜工作站
二次離子質譜工作站
-
 二次離子質譜探針
二次離子質譜探針
-
 GCxGC-TOFMS 2000全二維氣相色譜飛行時間質譜聯用系統
GCxGC-TOFMS 2000全二維氣相色譜飛行時間質譜聯用系統
















